焊錫膏
FLUX-ASF003
◆高黏著力使錫球裝載後保持穩定
◆殘渣可以溫水洗淨
◆經時變化後,仍維持高黏著力
實現狹小間距下,BGA的封裝印刷助焊劑與銲墊上

因助焊劑的高黏著力,抑制加熱時錫球的移動,實現BGA封裝
焊墊間距: 300 µm 焊墊大小: Φ180 µm
熔融性良好!!
|
錫球尺寸∅200 μm
|
錫球尺寸∅600 μm
|
|
|
加熱前
|
|
|
|
加熱後 |
 |
 |
[ 加熱條件 ]
150°C~180°C 94秒
220°C 46秒
最高溫度:250°C
加熱環境:大氣

洗淨性良好!!
[ 洗淨條件 ]
溫水 60°C 超音波 94秒
|
錫球尺寸∅200 μm
|
錫球尺寸∅600 μm
|
|
|
洗淨前
|
|
|
| 洗淨後 | 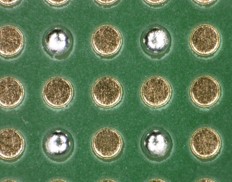 |
 |
經時變化後,仍維持高黏著力

|
基本特性 FLUX-ASF003
|
||||
|
鹵素含量
|
0.05wt%以下
|
|
||
|
黏度
|
55.0±4.0(Pa.s) 參考值 |
♦ 印刷用 |
||
|
TI
|
0.4±0.1
|
♦ 水溶性助焊劑 |
||
|
黏著力
|
160(gF) 參考值 |
|
||